多くの光学装置では、レンズ系を用いてパターンの投影を行っています。一般に投影レンズ系の設計は 幾何光学的な光線追跡によっておこなわれますが、投影像の特性評価は、幾何光学では十分に説明する ことができません。投影像の光強度分布の計算においては、波動光学的な計算が不可欠となります。 このような検討は、高度の光学技術を必要とする投影露光装置の改良、開発に応用されています。
被感光基板にはレジスト(感光材料)を塗布し、マスクパターンを転写して現像する ことによって、パターンが形成できます。
この方法は、簡単な構成でマスクの損傷を防止できますが解像度が劣化します。 解像度に影響する要因は主にマスクと被感光基板の間隔、露光光照明角度分布、波長等ですが これらの因果関係を理解することは重要です。
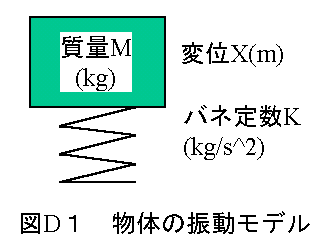
いきなり、レンズ系の投影像の光強度分布計算式の検討にはいる前に準備運動をしてみたいと思います。 図D1に物体の運動モデルを示します。このモデルにおいて下記の方程式が成立します。

(D1)式を満足する解の1例としては、A,Bを任意の定数として下記の 式があります。

(D2)式においてSQRT(K/M)の部分は角速度ωに相当する部分で振動の固有振動数を決定します。 また、定数Aは振動の振幅で任意の値をとることができます。さらにBは振動の位相であり、任意の角度 をとることができます。
言いかえると(D1)式は振動の固有振動数のみを決定し、振幅と位相は任意の値となることを示して います。
(1)式を満足する別の解として、A,Bを任意の定数として下記の複素関数があります。

(D2)式と(D3)式は基本的には同じことを意味しています。奇異に感じるかもしれませんが、(D2)式より (D3)式の方が数学的には扱いやすいため、振動を表す式として(D3)式が多くの場合で使用されます。 COS関数の場合括弧の中の角度の和が扱いにくいのに対して、指数関数の場合は角度の和は同じ指数 関数の積として扱えます。
(2)(3)式は変位Xを与える式ですが、エネルギーについて検討します。
運動エネルギーと位置ポテンシャルエネルギーは下記式となります。

振動のエネルギーについてみると、運動エネルギーと位置ポテンシャルエネルギーはベクトルの 絶対値が同じでベクトルの位相が180度ずれていることがわかります。
エネルギーのベクトルの絶対値の大きさは振動の振幅Aの自乗に比例しています。
一般的に波動光学では、振動の変位を「波動」と呼びます。また、光の「強度」は振動の振幅Aの 自乗とします。(時間tの項は無視します。)
光を別の表現をすると電磁波の一種であり、電場と磁場の周期的変化と言われています。 これを式で表わすと、

ここでzは距離であり、tは時間です。光の波動は距離(z)と時間(t)の周期関数と表わされ、複素関数と なっています。 波動の絶対値A(z)は光源からの距離(z)に反比例し、A(z)=A/zの関係があります 。
レンズ系の投影像の光強度計算において、最近の主流はFFT(Fast Fourier Transform)によるフーリエ変換 です。この計算手法は、光源は無限遠の平行光線をマスクパターンに照射し、マスクパターンを通過した光 の角度別の波動を求めることを特徴としている。また時間項ωtについて論じるません。
マスク透過後の波動説明図を図D2に示ます。

図2においてマスクに照射する光は平行光線 とし、光強度は1とします。
マスク面上の開口Aは透過特性f(x)を持つ。 ここで、f(x)は透過率と位相差を持つ。
座標xを透過した角度θ方向の波動は光軸中心 に対して、光路差β=x*SIN(θ)分の位相遅れが 生じます。
開口部の無次元化した大きさをΔx/λとします。
従って、マスク透過後の波動は下記式となります。

マスクパターンのx1~x2までの領域を通過した光の 波動は(D7)式の積分で求めることができます。

(8)式で1次元マスクパターンを通過した光のフーリエ変換像を求めることができます。 (8)式は波動であり 光強度にする場合は、波動の振幅の絶対値の自乗を求めます。
2次元マスクパターンについては、同様に下記式となります。

(9)式において記号は下記のように定義しています。
λ :波長
θ :回折光角度
φ :回折光角度
f(x,y) :マスクパターンの光透過特性
x1,x2 :マスクパターンの範囲
y1,y2 :マスクパターンの範囲
(1) 無収差、ベストフォーカス
マスクパターンに平行光線を照射するとフーリエ変換面にフーリエ変換像ができます。このフーリエ変換 像はレンズを通過すると焦点位置を球の中心とする球面波に変換されます。
もちろん実際のレンズでは、完全な球面波に変換されず誤差を生じます。(これを波面収差と言います。)
まずは、理想レンズにおける結像を論じたいと思います。
図D3に理想レンズにおける収束光の波動説明図を示します。
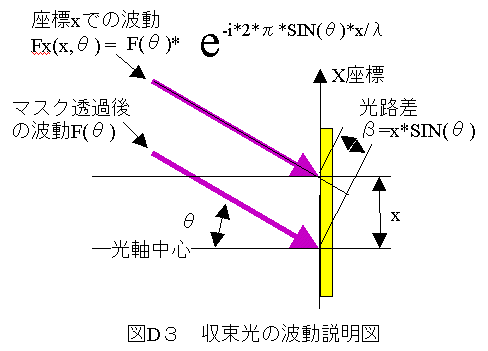
図3において光軸中心の波動はフーリエ変換後の 波動と一致します。
(無収差、ベストフォーカスの場合)
X座標のxの位置では光路差β=x*SIN(θ)を生じます。
(位相が進む。EXP(-i)→EXP(i)となる。)
従って、座標xでの波動は下記となります。

レンズの入射瞳を通過した光の角度範囲をθ1~θ2 とした場合、レンズを通過したx座標の波動は下記と なります。

(11)式は1次元の式ですが、同様な類推で2次元の式を求めます。

(D12)(D13)式が2次元での投影像の波動を与える式です。(D12)式はほとんどの計算条件で共通ですが、(D13)式 は、計算条件で変化します。(D13)式は無収差レンズでのベストフォーカスでの投影像の波動を与えます。
(2) 無収差デフォーカス
デフォーカスすると光路差βが変化します。この関係説明図を図D4に示します。
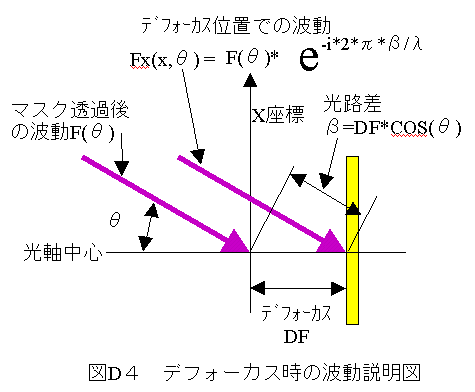
デフォーカスするとベストフォーカス時と比較 して、下記式の光路差が発生します。
β =DF* cos(θ) --------(D14)式
また、 cos(θ) は近似的に
cos(θ) ≒1- θ2/2 --------(D15)式
が成立します。
光路差において定数1は投影像のコントラストに は影響しません。
光路差がλ/4となるデフォーカス量を求める式は 下記のようになります。

(D16)式において、θ≒NAとして整理すると 下記のようになります。

(D17)式は波動光学では有名な関係式であり、投影光学系の理論焦点深度を与える式です。
すなわち、 (D17)式は波面の収差量がλ/4となるデフォーカス量を示しています。焦点深度の定義は 見方によってかわりますが、一般的には、波面の収差量λ/4がゆるされる限界とみることができます。
(3) 理想点光源の解像度の式
波動光学において有名なもうひとつの式に投影光学系の解像度(R)を与える下記式があります。

投影光学系での投影像の光強度分布を求める手法としては、フーリエ変換を用いた方法とベッセル関数を 用いた方法があります。
前者は平行光線をマスクパターンに照射することを基本としていますが、後者は理想点光源の投影を基本 としています。
(D18)式は後者の理想点光源の投影の式展開から誘導できます。(D18)式の値は理想点光源の投影像の光強度 が極小となる半径を示しています。従って、一般のマスクパターンの投影においては定数0.61は厳密な意味 を持つ訳ではありません。しかし、解像度の定義は明確にすることが難しいしいため、定数0.61を一般的に 用います。
ベッセル関数を用いた投影光学系での投影像の光強度分布計算方法は汎用性にとぼしく、フーリエ変換法 に劣ります。しかも、計算式の誘導説明はかなり複雑なものになります。ここでは、 (D18)式の誘導説明は 省略します。(「波動光学」(岩波書店)等の専門書には、 (D18)式の誘導説明があります。)
(4) 波面収差と光路差β
2次元でのデフォーカスを考慮した光路差βの式は下記式となる。

(D19)式は正確な2次元でのデフォーカスを考慮した光路差βの式です。
(D19)式の「cos(θ)*cos(φ)」の項は、計算を行う上で少し厄介な形をしています。 この項は2次元での積分計算を1次元に分解できない形です。(計算時間を無視すれば2次元積分は可能。)
ここで、
cos(θ) ≒1- θ2/2≒1-(sin(θ))2/2
cos(φ) ≒1- φ2/2≒1-(sin(φ))2/2
の近似式の関係を用いて、(D19)式に代入し、定数項と微小項を無視して整理すると

近似式(D20)式をみると角度変数sin(θ)、 sin(φ)に対して位置変数x,yは1次の関係式になっており、 デフォーカスDFに関しては2次の関係になっています。
言いかえると1次の波面収差は結像位置のオフセットを決定し、2次の波面収差はデフォーカスを決定 します。
光路差βを与える一般式は、
β= β(θ, φ) --------(D21)式
となり、 β(θ, φ) はどのような関数であってもよく、またβ(θ, φ) を実測データに基づく数表でもよいの ですがこの場合は、2次元の積分を行う必要があります。
計算で扱いやすい波面収差として、角度変数θ、φの3次関数で与えられる光路差を生じる収差「コマ収差」 、4次関数で与えられる光路差を生じる収差「球面収差」があります。
「コマ収差」 「球面収差」を考慮した光路差βの式は下記となります。

(D21)式において、NAは投影光学系のNAの最大角度で波面収差を正規化するための定数です。 Ax3はx方向コマ収差で単位はλです。同様にAy3はy方向コマ収差、Ax4はx方向球面収差、Ay4はy方向球面 収差です。
本来は、あらゆる波面収差に応じた投影像の波動(または光強度分布)を求めることが可能ですが、実際 の計算量を考慮するとある程度の近似式を用いることはやもえません。
(D21)式はsin(θ)の項とsin(φ)の項が分離しており、1次元の積分に分解可能です。
以上の説明においては、照明はマスクパターンに垂直に照射する平行光線を前提として、解説しました。
しかし、実際の投影光学系における照明は垂直に照射する平行光線ではなく、照明光源の傾斜と広がりを 持っています。
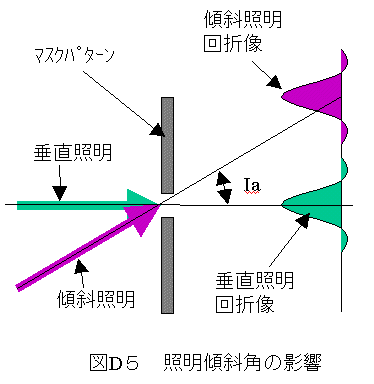
照明の傾斜角の影響関係図を図D5に示します。
図D5に示すようにマスクパターンに傾斜した照明 が照射されると回折像の角度は傾斜角度分シフト します。
また、回折像の分布は垂直照明と同じで単純に 中心角度がシフトします。
もう一つ重要な仮定が必要となります。
それは、角度の異なる光が干渉するか?あるいは 干渉しないか?という仮定です。
一般的な条件において、角度の異なる照明は干渉 しないと仮定します。
この仮定は、光源は無限遠(あるいはケーラ照明) にあり、異なる角度の照明は異なる光源からでたと 仮定されます。
異なる光源からの光は時間的に位相がランダムと仮定します。従って、異なる角度の照明は干渉しませ ん。この場合の数学的な処理は、光の波動の和ではなく、光の強度の和として扱います。
俗語かもしてませんが、光の波動の和を「ベクトル和」、光の強度の和を「スカラー和」といって区別 します。
すなわち、干渉性の光を扱う場合は「ベクトル和」の処理を行い、非干渉性の光を扱う場合は「スカラー 和」の処理を施します。
一般に波動光学では、波動の時間項は無視して計算しますが、光の条件によって、 「ベクトル和」と 「スカラー和」の使いわけを行います。
では、照明の傾斜角度が連続的に変化する照明光の広がりがある場合は、どうすればよいでしょうか?
実際には、このようなケースがほとんどです。しかし、投影像の光強度分布を計算するにあたって、 照明角度を連続として計算することはできません。
複数の傾斜角を持つ照明光の「スカラー和」として投影像の光強度分布を計算します。この場合、照明 光線の数を多くすれば誤差が減りますが、計算時間が長くなるためあまり多くもできません。
一般的に照明光源は連続的な波長を持っています。これも上記の角度の異なる照明と同様に「スカラー和」 として扱います。
この場合もより多くの波長について、 「スカラー和」を求めればよいのですが、同様に計算時間が長く なるためあまり多くもできません。
VBAソフト「投影露光.xls」をダブルクリックして起動した後、 シート「デフォルト条件」の条件表の内容をシート「IN_FM」にコピーします。
次にシート「操作」の「計算実行」ボタンを押します。
計算結果の概要が表示されます。
シート「デフォルト条件」の内容は下記表に示す通りです。
| No | 記号 | 値 | 説明 |
| 1 | N | 40 | データ範囲分割数(整数最大128まで) |
| 2 | dx | 0.02 | データの刻み幅、単位(μm) |
| 3 | WL | 0.193 | 波長、単位(μm) |
| 4 | NA | 0.8 | 投影レンズNA |
| 5 | Sig | 0.6 | 照明σ |
| 6 | Iax | 0 | 照明X方向傾き、単位(rad) |
| 7 | Iay | 0 | 照明X方向傾き、単位(rad) |
| 8 | DF | 0 | デフォーカス量、単位(μm) |
| 9 | Ax3 | 0 | X方向コマ収差、単位(λ) |
| 10 | Ax4 | 0 | X方向球面収差、単位(λ) |
| 11 | Ay3 | 0 | Y方向コマ収差、単位(λ) |
| 12 | Ay4 | 0 | Y方向球面収差、単位(λ)(整数) |
| 13 | PN | 5 | 矩形パターン数を設定(整数最大1000まで) |
| No | U0r[i] | U0i[i] | X1刻み | X2刻み | Y1刻み | Y2刻み |
| 0 | 1 | 0 | -20 | -17.5 | -20 | 20 |
| 1 | 0 | 1 | -12.5 | -7.5 | -20 | 20 |
| 2 | 1 | 0 | -2.5 | 2.5 | -20 | 20 |
| 3 | 0 | 1 | 7.5 | 12.5 | -20 | 20 |
| 4 | 1 | 0 | 17.5 | 20 | -20 | 20 |
上記の表は波長193nm、NA0.8の投影露光装置で0.1μmL/Sのレベンソン型 位相マスクパターンを投影した場合の光強度分布を計算します。
マスクパターンは0.02μm刻みで40刻みの範囲で定義しています。
またマスクパターンは5個の透過エリアで定義しています。
(1)U0r[i]は波動の実数部の値を入力します。
(2)U0i[i]は波動の虚数部の値を入力します。
(3)X1刻みは透過エリアのX方向最小位置を単位(刻み)で入力します。 この値は小数点を使用できます。
(4)X2刻みは透過エリアのX方向最大位置を単位(刻み)で入力します。 この値は小数点を使用できます。
(5)Y1刻みは透過エリアのY方向最小位置を単位(刻み)で入力します。 この値は小数点を使用できます。
(6)Y2刻みは透過エリアのY方向最大位置を単位(刻み)で入力します。 この値は小数点を使用できます。
注)繰り返しパターンの場合、全体のパターンエリアは繰り返しピッチの 整数倍に設定する必要があります。

「デフォルト条件」の計算結果を図D6に示します。
図D6から以下のことが分かります。
(1)ベストフォーカスでは0度位相部と180度位相部の光強度が等しくなる。
(2)フォーカスがズレると0度位相部と180度位相部の光強度のバランスが 狂ってくる。
(3)波長192nm、NA0.8の投影露光装置で0.1μmL/Sの位相シフトマスクを 投影した場合の、許容焦点深度は±0.1μm程度となる。
(4)レジストの厚さ、ウェーハの平坦度等の誤差を考慮した場合、 許容焦点深度は±0.1μmという値はかなり厳しいものとなります。