図8-1に2層レジストプロセスの原理図を示します。
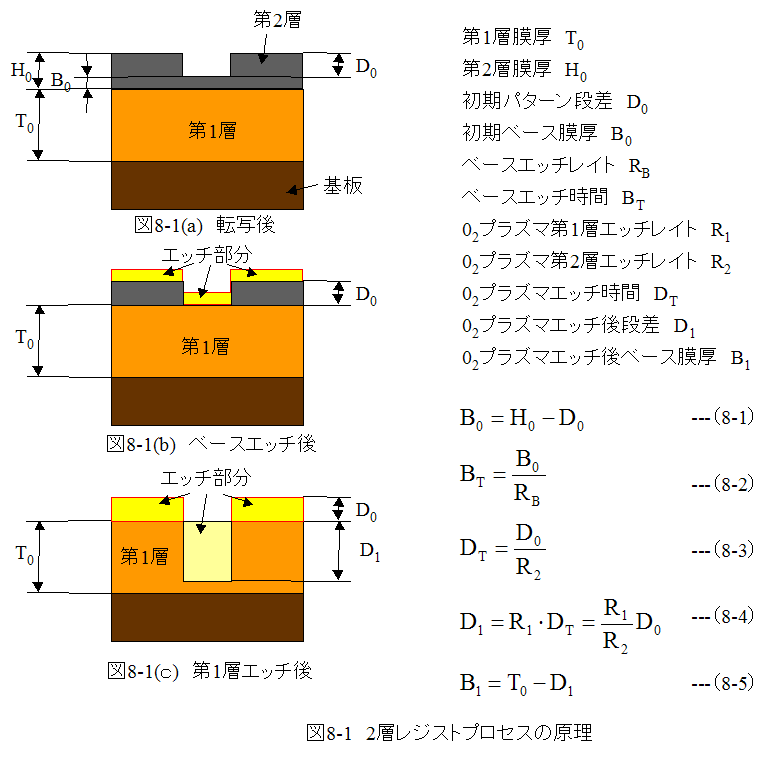
- 図8-1(a)に転写後の断面形状を示します。
第2層のベース膜厚B0は(8-1)式で求められます。
ここで第2層のベースエッチレイトをRBとすると ベースエッチ時間BTは(8-1)式で求められます。
- 図8-1(b)にベースエッチ後の断面形状を示します。
図8-1(b)において、第2層の段差高さは初期の段差D0 に等しくなります。
次にO2プラズマエッチで第2層がなくなるエッチ時間を求めます。
O2第2層エッチレイトをR2とすると O2プラズマエッチ時間DTは(8-3)式で求められます。
- 図8-1(c)にO2プラズマエッチ後の断面形状を示します。
O2プラズマエッチにより、第2層をマスクとして第1層がエッチされます。
O2第1層エッチレイトをR1とすると 第1層の段差D1は(8-4)式で求められます。
(8-4)式から、段差D1は、第1層と第2層のO2プラズマエッチレイトの 比で増幅できることがわかります。
このとき、第1層のベース膜厚B1は(8-5)式で求められます。
第1層のベース膜厚B1がほぼゼロのなる条件がベストです。
- 評価レジスト
・ノーマル厚膜用のスピンコートレジストの配合比 CN-325:A-BPE-10:T2325:M0084:I-907=1:1:1:10:0.3
・Si系薄膜用のスピンコートレジストの配合比 AC-SQ:A-BPE-10:M0084:I-369=1:1:26:0.2
上記レジストにおいて、希釈剤M0084の混合比は自由に変更でsきます。
- O2プラズマ処理装置
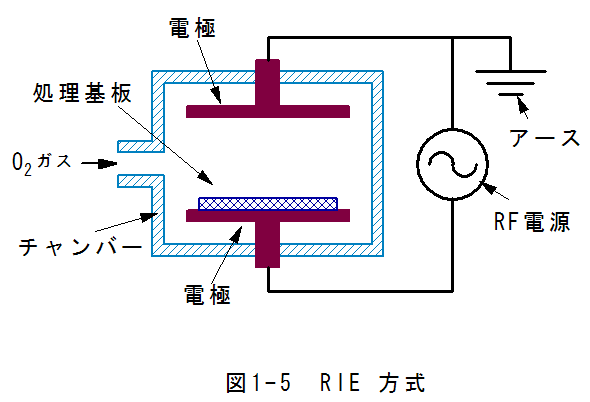 図1-5に示すRIE型(Reactive Ion Etching)のO2プラズマ処理装置を使用します。
図1-5に示すRIE型(Reactive Ion Etching)のO2プラズマ処理装置を使用します。
- O2プラズマエッチ条件
・処理モード ハード 圧力優先
・RFパワー 100W
・処理圧力 1Pa
・O2ガス流量 10ml/min

- O2プラズマエッチレイトの評価結果
O2プラズマエッチレイトの評価結果を図8-2に示します。
この結果から、アスペクト比を約3.2倍に増幅可能なことがわかります。
Si系レジストの配合比を変更することにより、さらなる増幅も可能です。
以下に2層レジスト処理条件例を示します。
- カップリング処理
・O2プラズマ ハード、300W、200s
・KBM-5103:M0084=1:1000 滴下
・スピンアウト 5000rpm 60s
・ベーク 120℃ 5分
- スピンコート
・ノーマル厚膜用のスピンコートレジストの配合比 CN-325:A-BPE-10:T2325:M0084:I-907=1:1:1:10:0.3
・立上り 3s 、回転数5000rpm、 15s
・ベーク 80℃ 1分
- 露光
・照度 50mW/cm2 5s(窒素雰囲気中)
- スピンコート
・Si系薄膜用のスピンコートレジストの配合比 AC-SQ:A-BPE-10:M0084:I-369=1:1:26:0.2
・立上り 3s 、回転数5000rpm、 15s
・ベーク 80℃ 1分
- ナノインプリント
・照度 50mW/cm2 2s
2層レジストプロセスの利点
・ナノインプリント時のアスペクト比を小さく設定できます。これにより、スタンパの欠陥が低減し、 離型性も改善されるため、欠陥の発生が少なくなります。
・第1層を厚く設定すると、第1層がクッションとして機能します。付着した異物の大きさが第1層の 膜厚以下の場合、第1層のクッション層が応力集中を防止して、石英スタンパのパターン部の損傷 を防止します。これにより欠陥の発生が少なくなります。
また、クッション層は異物があった場合の非転写領域を小さくします。
・クッション層が無い場合ナノインプリントは、100nm以下の微小異物にも敏感に反応してしまいます。
しかし、いかにクリーン化の努力を行っての100nm以下の微小異物をなくすのは困難です。
・樹脂スタンパのようにクッション機能をスタンパ側にもたす発想もありますが、この場合、位置精度の 保障ができなくなります。位置精度高めるには、どうしても石英ガラスのように安定な材料を使用せざるえません。
2層レジストプロセスは、高位置精度で無欠陥転写を実現するために不可欠な技術です。